
Рефераты по коммуникации и связи
Рефераты по косметологии
Рефераты по криминалистике
Рефераты по криминологии
Рефераты по науке и технике
Рефераты по кулинарии
Рефераты по культурологии
Рефераты по зарубежной литературе
Рефераты по логике
Рефераты по логистике
Рефераты по маркетингу
Рефераты по международному публичному праву
Рефераты по международному частному праву
Рефераты по международным отношениям
Рефераты по культуре и искусству
Рефераты по менеджменту
Рефераты по металлургии
Рефераты по налогообложению
Рефераты по оккультизму и уфологии
Рефераты по педагогике
Рефераты по политологии
Рефераты по праву
Биографии
Рефераты по предпринимательству
Рефераты по психологии
Рефераты по радиоэлектронике
Рефераты по риторике
Рефераты по социологии
Рефераты по статистике
Рефераты по страхованию
Рефераты по строительству
Рефераты по схемотехнике
Рефераты по таможенной системе
Сочинения по литературе и русскому языку
Рефераты по теории государства и права
Рефераты по теории организации
Рефераты по теплотехнике
Рефераты по технологии
Рефераты по товароведению
Рефераты по транспорту
Рефераты по трудовому праву
Рефераты по туризму
Рефераты по уголовному праву и процессу
Рефераты по управлению
Реферат: Конструктивно-технологические разновидности МДП-транзисторов
Реферат: Конструктивно-технологические разновидности МДП-транзисторов
БЕЛОРУССКИЙ ГОСУДАРСТВЕННЫЙ УНИВЕРСИТЕТ ИНФОРМАТИКИ И РАДИОЭЛЕКТРОНИКИ
Кафедра РЭС
РЕФЕРАТ
На тему:
«КОНСТРУКТИВНО-ТЕХНОЛОГИЧЕСКИЕ РАЗНОВИДНОСТИ МДП-ТРАНЗИСТОРОВ»
МИНСК, 2008
Конструкции МДП-транзисторов в микросхемах с алюминиевой металлизацией. Вариант конструкции активного транзистора с прямоугольным каналом и со средним значением крутизны передаточной характеристики представлен на рис.1. Под алюминиевым затвором находится тонкий слой термически выращенного окисла кремния (0,05...0,10 мкм. За пределами области канала толщина окисла составляет 1 мкм. Этот сравнительно толстый слой окисла выполняет функции защитного диэлектрика, позволяет существенно снизить значения паразитных емкостей сигнальных шин и повысить пороговое напряжение паразитных МДП-транзисторов (рис.1) в местах прохождения алюминиевых проводников над диффузионными шинами питания.
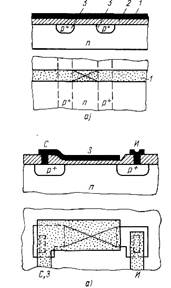
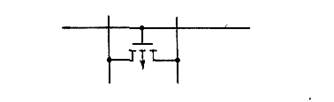
Рис.6.1 Чертеж топологии (а) и электрическая схема (б) паразитного транзистора.
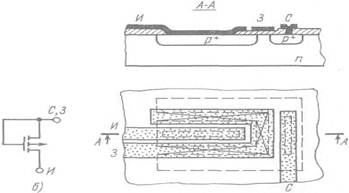
Рис.1 Конструкция (а) и электрическая схема (б) нагрузочного р-канального МДП-транзистора
Рис.2 Конструкция МДП-транзистора с П-образным каналом
В нагрузочных транзисторах значение крутизны передаточной характеристики может быть небольшим, и соответственно отношение длины канала к его ширине выбирается таким, чтобы при заданной крутизне нагрузочный транзистор занимал минимальную площадь (рис.1). В том случае, когда для обеспечения высоких значений крутизны характеристик активного транзистора отношение bк/lК должно быть равно или больше 20, с целью экономии площади рекомендуется П-образная форма канала (рис.2).
Для повышения степени интеграции в микросхемах, требующих последовательного и параллельного соединения транзисторов, области истоков или стоков МДП-транзисторов могут быть объединены (рис.3). На рис.4 приведена конструкция инвертора, в которой диффузионная область стока активного VT1 и истока нагрузочного VT2 МДП-транзисторов объединены.
Освоение производства р-канальных МДП-транзисторов с индуцированным каналом и алюминиевым затвором позволило получить следующие параметры МДП-структур: минимальная длина канала 10...12 мкм (по затвору 20 мкм), глубина залегания р-п переходов 2,5 мкм, боковая диффузия под окисел 2 мкм, толщина подзатворного диэлектрика 0,12...0,15 мкм, напряжение питания 12 В, пороговое напряжение (-4+0,5) В, удельное поверхностное сопротивление диффузионных областей истока и стока и диффузионных шин 50...100 Ом/т, пробивное напряжение р-п переходов областей истока и стока свыше 30 В, пороговое напряжение паразитных транзисторов свыше 40 B, подвижность дырок в канале около 200 см2/(B·c), плотность поверхностных состояний 1011…1012 см–2.
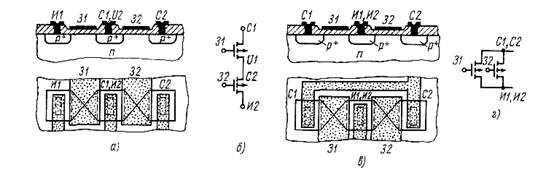
Рис 3. Фрагменты топологии (а, в) и электрические схемы (б, г) при параллельном (а, б) и последовательном (в, г) включении транзисторов.
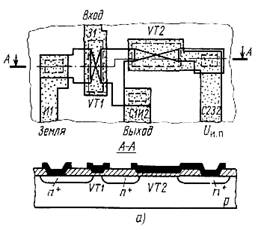
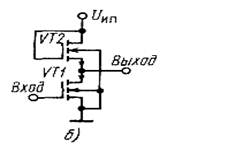
Рис.4. Конструкция (а) и электрическая схема (б) инвертора на МДП-транзисторах с нелинейной нагрузкой и алюминиевой металлизацией.
На таких структурах были созданы одни из первых логических интегральных МДП-микросхем с минимальным временем задержки на вентиль 80...100 нс и основным показателем качества микросхем - произведением мощности на задержку 60...80 пДж. Хорошо отработанная технология производства и меньшая стоимость способствуют тому, что микросхемы на р-МДП-транзисторах выпускают до сих пор, несмотря на худшие характеристики.
Усовершенствование технологических операций, в первую очередь тех, которые направлены на снижение встроенного в окисле заряда и плотности поверхностных состояний, привело к созданию интегральных n-канальных МДП-транзисторов. Преимуществами микросхем на таких транзисторах являются: повышенное в 2...3 раза быстродействие, совместимость по знаку и уровню питающего напряжения с ТТЛ-микросхемами на биполярных транзисторах.
Применение кремниевых подложек с рабочей поверхностью, ориентированной по кристаллографической плоскости (100), приводит к уменьшению плотности поверхностных состояний до 1011 см–2 и к еще большему снижению порогового напряжения.
Возможности управления пороговым напряжением расширяются, если использовать многослойный подзатворный диэлектрик. В этом случае в игру вступают дополнительный заряд на границе диэлектриков, объемный встроенный заряд дополнительного диэлектрика, заряд, обусловленный поляризацией диэлектриков.
МНОП-транзисторы. Одним из вариантов МДП-транзистора с многослойным диэлектриком является структура металл - нитрид кремния - окисел кремния - полупроводник (сокращенно - МНОП). Пленка нитрида кремния обладает высокой пассивирующей способностью (поскольку скорость дрейфа положительных ионов в нитриде на несколько порядков меньше, чем в окисле) и более высокой диэлектрической проницаемостью. Уже одно это позволило бы снизить пороговое напряжение на 1...1.5. В и повысить удельную крутизну.
Однако использовать один только нитрид кремния в качестве подзатворного диэлектрика оказалось невозможно из-за появления заряда на границе раздела кремний - нитрид кремния, зависящего от напряжения на затворе. Это приводит к непостоянству порогового напряжения приборов и к его гистерезису.
Использование МНОП-структуры позволило получить приборы, в которых эквивалентная толщина диэлектрика уменьшается примерно в полтора раза, пороговое напряжение снижается в среднем на 1 В. Эта же МНОП-структура при толщине пленки SiO2 0,005 мкм (5 нм) может быть использована в качестве элемента памяти в ППЗУ с электрическим стиранием и записью информации.
МОАП-транзисторы. Использование А12Оз в качестве второго подзатворного диэлектрика обусловлено его способностью создавать на границе с SiO2 встроенный отрицательный заряд, что позволяет получать n-канальные приборы с индуцированным каналом, работающие в режиме обогащения при пороговом напряжении, примерно равном +1 В.
Конструкции МДП-транзисторов с поликремниевыми затворами. В МДП-транзисторах с алюминиевым затвором имеются значительные по площади области перекрытия затвора с областями истока и стока (см. Рис.6.1), что, с одной стороны, необходимо для надежного обеспечения формирования канала транзисторов, с другой - приводит к наличию. паразитных емкостей Сзи и Сзс, снижению быстродействия МДП-микросхем. Уменьшение размеров областей перекрытия затруднено ошибками совмещения фотошаблонов металлизации с областями истока и стока, т.е. разрешающей способностью фотолитографии по алюминиевой металлизации, которая не превышает ±1 мкм.
Использование поликремния в качестве материала затвора (рис.5) позволило получить ряд существенных конструктивно-технологических преимуществ и значительно повысить параметры МДП-приборов.
Значительно уменьшена глубина залегания р-п переходов истока и стока (до 2...1 мкм) и боковой диффузии (до 0,6...1,4 мкм), а вместе с тем значительно уменьшены перекрытие затвором областей истока и стока и площади р-п переходов, и, таким образом, существенно снижены значения соответствующих паразитных емкостей. Наименьшие величины перекрытий получены при использовании ионного легирования при формировании областей истока и стока, однако сопротивление поликремниевых шин при этом остается высоким. Для увеличения проводимости шин используют комбинацию диффузионного и ионного легирования.
Совместимость материала затвора с материалами защитного слоя (например, поликремния и пиролитически нанесенного окисла кремния) позволила значительно сблизить контакты стока и истока, уменьшить размеры этих областей и всего прибора в целом, повысить степень интеграции МДП-микросхем.
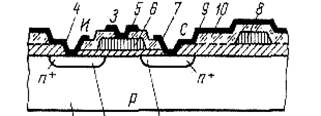
1 2 3
Рис.5. Структура МДП-транзистора с поликремниевыми затворами: 1 - подложка р-типа; 2, 3 - диффузионные n+ - области истока и диффузионных шин (первый уровень разводки), 4, 5, 7 - алюминиевые контакты к истоку, затвору и стоку;, 6 - поликремниевый затвор; 8 - проводник из легированного поликремния (второй уровень разводки); 9 - алюминиевая шина (третий уровень разводки); 10 - межслойный диэлектрик (SiO2, БСС, ФСС)
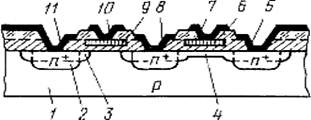
Рис.6. Структуры МДП-транзисторов с индицированным и встроенным каналами, истоки и стоки которых сформированы комбинацией диффузии и ионного легирования: 1 - подложка р-типа; 2 - диффузионная n+-область истока; 3 - ионно-легированная n+-область истока; 4 - встроенный ионно-легированный n-канал; 5, 7,8, 10, 11 - алюминиевые выводы истоков, стоков и затворов; 6, 9 - поликремниевые затворы.
Уменьшена ширина канала до 4...6 мкм за счет более точного формирования конфигураций истока, стока и затвора и меньшего перекрытия этих областей. Снижение толщины подзатворного диэлектрика до 0,07...0,1 мкм позволило резко увеличить крутизну характеристики транзисторов и повысить быстродействие микросхем.
Применение поликремния в качестве материала затвора дает снижение контактной разности потенциалов φмп и уменьшение порогового напряжения. К этому же результату приводит уменьшение плотности заряда поверхностных состояний Qss благодаря эффективной защите подзатворного диэлектрика материалом затвора и отжиг этого диэлектрика при высоких температурах в процессе проведения операций легирования кремния. Снижение пороговых напряжений дало возможность перейти к использованию источников питания с рабочим напряжением 5 В, снизив потребляемую мощность БИС.
Освоение технологии изготовления МДП БИС с поликремниевыми затворами транзисторов, сочетающей диффузионное и ионное легирование, позволило создать в составе микросхем МДП-транзисторы со встроенным каналом, работающие в режиме обеднения (Рис.6). Нагрузочные транзисторы n-МДП-типа со встроенным каналом обладают более высоким быстродействием, лучшей помехоустойчивостью и занимают вдвое меньшую площадь, чем нагрузочные транзисторы, работающие в режиме обогащения (см. рис.2, 4) при той же потребляемой мощности.
Все указанные факторы в сочетании позволили создать МДП БИС с минимальной задержкой на один элемент 1...4 не и значительно уменьшить такой важный параметр, как произведение мощности на задержку (1...4 пДж), что уже вплотную подходит к аналогичным параметрам БИС на биполярных транзисторах.
Конструкции Д-МДП-транзисторов. Конструкция Д-МДП-транзистора разработана специально для обеспечения высокого быстродействия за счет уменьшения длины канала до субмикронных размеров. Короткий канал получают по принципу формирования тонкой базы в биполярном транзисторе - за счет медленного, хорошо контролируемого и управляемого процесса диффузии (поэтому Д-МДП, т.е. диффузионный МДП-транзистор). В этом транзисторе области канала р-типа и истока n+-типа формируются в процессе двух диффузий в одно и то же окно в окисной маске. Конструкция Д-МДП-транзистора не требует высокой точности совмещения затвора с областями истока и стока, как в обычном МДП-транзисторе. В связи с этим оказалась возможной реализация МДП-структур с длиной канала 0,4...1 мкм даже при ограниченных возможностях фотолитографического процесса по разрешающей способности. Короткий канал формируется в приповерхностной области. Кремния p - типа электропроводности в промежутке между двумя р-п переходами. Число носителей тока в этом индуцированном канале определяется напряжением на затворе, а скорость их перемещения - напряжением, приложенным между истоком и стоком. Произведение числа носителей на их скорость пропорционально току стока. В и-канальных Д-МДП-транзисторах при длине канала менее одного микрона электроны, инжектированные из области истока, даже при сравнительно небольших напряжениях на стоке приобретают значительную скорость.
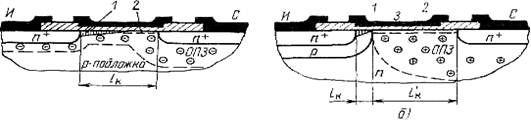
Рис.7. Структура обычного n-канального МДП-транзистора (а) и диффузионного n-канального Д-МДП-транзистора (б): / - область канала; 2 - область дрейфа электронов.
В обедненной n-области между каналом и стоком при нормальных смещениях (Uc>Uнас) электроны, прошедшие канал, инжектируются в область объемного пространственного заряда, прилегающую к n+-области стока, и дрейфуют к стоку в сильном электрическом поле. Такая же область дрейфа существует и в обычных МДП-транзисторах при Uc>Uнас (рис.7)
Таким образом, несмотря на различия в конструкциях, принцип работы Д-МДП - и МДП-транзисторов одинаков. Но в производстве Д-МДП-транзисторов использованы достижения как биполярной технологии (малое расстояние между двумя р-п переходами), так и технологии изготовления МДП-структур (формирование тонкого подзатворного диэлектрика с малой толщиной, низкой дефектностью и плотностью поверхностных состояний).
Освоение технологии микросхем на Д-МДП-транзисторах с использованием эпитаксиальных структур позволяет, кроме того, формировать на одной и той же подложке биполярные п-р-п-транзисторы и изолированные от них Д-МДП-транзисторы (рис.8), что имеет исключительное значение для производства как аналоговых (например, операционных усилителей), так и логических микросхем.
Перекрытие электродом затвора обедненной области объемного заряда (рис.7, б) дает лишь незначительный вклад в паразитную емкость Сзс, но наличие этой области позволяет повысить рабочее напряжение прибора до нескольких сотен вольт. Короткий канал и малая емкость Сзс позволили увеличить быстродействие микросхем с Д-МДП-транзисторами примерно в 5 раз при том же минимальном проектном геометрическом размере, что и в БИС на обычных МДП-транзисторах: значения времен переключения и задержки в логических микросхемах на Д-МДП-транзисторах составляют 1 не и менее. Пробивное напряжение Д-МДП-транзисторов составляет 300...400 В.
В связи с малой плотностью размещения элементов в кристалле маловероятно, что Д-МДП-транзисторы будут широко использоваться в БИС, но благодаря своим уникальным свойствам они найдут применение в быстродействующих переключающих устройствах с высоким рабочим напряжением и в устройствах большой мощности.
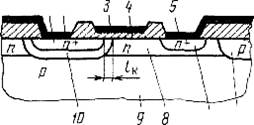
Рис.8. Структура планарно-эпитаксиального Д-МДП-транзистора: 1,7-диффузионныеобласти истока и стока; 2,5-шины алюминиевой металлизации; 3 - затвор; 4 - подзатворный тонкий окисел; 6 - изолирующая область; 8 - n-эпитаксиальный слой, 9 - подложка; 10 - область получаемая методом двойной диффузии для формирования канала транзистора.
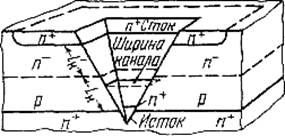
Рис 9. Фрагмент структуры кристалла с V-образным углублением для формирования V-МДП-транзистора.
Конструкции V-МДП-транзисторов. Все рассмотренные ранее МДП-транзисторы имеют планарную конструкцию, т.е. являются двумерными. V-МДП-технология добавляет в конструкцию МДП-транзисторов третье измерение, позволяя формировать исток прибора под его затвором и стоком, а не рядом с ними. Это третье измерение дает V-МДП-приборам преимущества как по быстродействию, так и по. плотности упаковки перед такими структурами, как п-канальные МДП-приборы с кремниевыми затворами.
Собственно говоря, термин «V-МДП-транзистор» относится к МДП-приборам, в которых буква V означает, во-первых, вертикальное направление протекания тока от расположенного в подложке истока к расположенному над ним стоку и, во-вторых, способ формирования приборов селективным вытравливанием в исходной заготовке углубления V-образного сечения (рис.9). V-МДП-транзистор получают на боковых стенках этого углубления. Особо следует отметить, что n+-исток, расположенный под n+-стоком, вообще не требует для своего формирования дополнительной площади на поверхности пластины, что обусловливает высокую компактность V-МДП-структуры. Кроме этого, истоковая область n+-типа выполняет роль земляной шины и не требует, как это бывает в других конструктивно-технологических вариантах, дополнительной площади кристалла для заземляющих шин.
Пирамидальная ямка вытравливается на такую глубину, чтобы она пересекла ионно-легированный слой n+-типа и эпитаксиальный слаболегированный р-слой, диффузионно-легированный n–-слой, достигнув вершиной высоколегированной подложки n+ - типа. Сечение р-слоя служит основой для формирования канала. Этот слой имеет глубину менее 1 мкм, его сечение плоскостями V-образного углубления определяет длину V-МДП-транзистора. Ширина канала в V-МДП-транзисторе получается большой, так как этот канал расположен по всему периметру V-образного углубления. Поскольку ширина канала определяет максимальный ток транзистора и его усиление, постольку V-МДП-транзисторы можно непосредственно сопрягать с системами, требующими больших управляющих токов, например со схемами, содержащими большое количество ТТЛ-нагрузок, светодиодными индикаторами и даже небольшими электродвигателями.
Слой подзатворного диэлектрика формируется на поверхности V-образного углубления (рис.10). В качестве материала затвора применяют алюминий либо поликремний. Область объемного пространственного заряда выполняет в V-МДП-транзисторе ту же роль, что и обедненная область пространственного заряда в Д-МДП-транзисторе: увеличивает пробивное напряжение транзистора, дает пониженные значения паразитной емкости Сзс.
Трехмерность V-МДП-транзисторной структуры является фактором существенного повышения плотности упаковки БИС.
В связи с низким выходом годных и ограниченных логическими возможностями перспективы создания V-МДП-БИС невелики. Но такие структуры обладают уникальными способностями управления очень большими токами с высокой скоростью их переключения. Они нашли применение в звуковых высококачественных усилителях мощности, в широкополосных усилителях, в источниках вторичного электропитания для преобразования постоянного тока в переменный при меньших затратах, массе и габаритных размерах, чем традиционные источники питания.
Конструкции МДП-транзисторов на диэлектрической подложке. Использование структур с эпитаксиально выращенным на диэлектрической подложке (сапфир или шпинель) слоем монокристаллического кремния толщиной 0,7...2,0 мкм с целью изготовления МДП-транзисторов целесообразно, так как позволяет существенно снизить паразитные емкости транзистора и коммутационных проводников, избавиться от паразитных транзисторных структур, упростить технологию изготовления МДП-приборов. Транзисторы формируются в изолированных друг от друга островках, что позволяет уменьшить практически до нуля паразитные межэлемент'ные связи через подложку. Диффузия для формирования истока и стока (рис.11) проводится на всю глубину эпитаксиального слоя, что позволяет получать вертикальные р-п переходы малой площади с малыми емкостями.
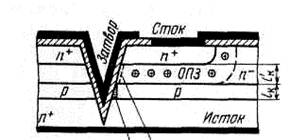
Рис.10 Структура V-МДП-транзистора: / - область канала; 2 - область дрейфа электронов.

Рис.11. Структура МДП-транзистора на диэлектрической (сапфир) подложке: / - подложка; 2, 4 - исток и сток; 3 - эпитак-сиальная р-область; 5, 8-шины металлизации; 6 - подзатворный тонкий диэлектрик; 7-затвор.
МДП-структуры на диэлектрической подложке обладают существенно более высоким быстродействием по сравнению с аналогичными структурами на кремниевой подложке и позволяют, кроме того, несколько сэкономить площадь при создании МДП БИС.
ЛИТЕРАТУРА
1. Ненашев А.П. Конструирование радиоэлектронных средств: Учеб. для радиотехнических спец. вузов. – Мн.: Высшая школа, 2000.
2. Основы конструирования изделий радиоэлектроники: Учеб. пособие / Ж.С. Воробьева, Н.С. Образцов, И.Н. Цырельчук и др. – Мн.: БГУИР, 2001